В.В. Побединский, Н.В. Рогозин, Е.Н. Бормонтов
1АО «НИИЭТ», 394033, Воронеж, ул. Старых Большевиков, д. 5;
2ФГБОУ ВО «ВГУ», 394018, Воронеж, Университетская площадь, д. 1
Опубликовано в научно-техническом журнале “Электронная техника. Серия 2. Полупроводниковые приборы”. Выпуск 4 (255) 2019, с. 27-34.
Рассмотрена система перераспределения контактных площадок кристаллов полупроводниковых изделий на основе платиновой металлизации и возможность её адаптации к существующим полупроводниковым приборам с медной металлизацией кристаллов в составе полупроводниковых пластин в технологии сборки методом «flip-chip», проанализирована возможность изменения размеров и геометрии существующих контактных площадок под проволочную микросварку.
Ключевые слова: система перераспределения контактных площадок, платиновая металлизация, монтаж методом «flip-chip», многослойная металлизация контактных площадок, адгезионный слой, барьерный слой, репассивирующий слой
PLATINUM MATALLIZATION IN SEMICONDUCTOR DIES CONTACT PADS REDISTRIBUTION SYSTEM FOR «FLIP-CHIP» DIE PACKAGING TECHNOLOGY
V.V. Pobedinsky 1,2, N.V. Rogozin 1, E.N. Bormontov 2
1Joint Stock Company «Scientific Research Institute of Electronic»,394033, Voronezh, Staryh Bol’shevikov st.,5;
2Federal State-Financed Educational Institution of Higher Professional Education «Voronezh State University», 394018, Voronezh, Universitetskaya sq., 1
Semiconductor dies contact pads redistribution system based on platinum metallization and its adaptation to semiconductor wafers with copper metallization regarding to “flip-chip” packaging technology was considered. Ability of changing the size and geometry of existing contact pads for wirebonding die packaging technology was analyzed.
Keywords: contact pads redistribution system, platinum metallization, flip-chip” packaging technology, multilayer contact pad metallization, adhesion layer, barrier layer, repassivation layer
Введение
Электрические соединения между полупроводниковым кристаллом и подложкой (корпусом) могут быть реализованы с помощью микросварки проволокой, пайкой на припойные шарики или наклейкой с помощью электропроводящих адгезивов. Для такого рода электрических соединений верхние уровни металлизации полупроводниковых кристаллов обычно выполнены из алюминия, меди или золота [1]. Одно из технических требований технологии «flip-chip» для обеспечения надёжности электрических соединений − верхние уровни металлизации контактных площадок кристаллов под припойный шариковый вывод являются многослойными. В структуру такой металлизации входят диффузионный барьерный, адгезионный и защитный слои [2]. После подготовки контактных площадок путём создания многослойной металлизации в ходе технологического процесса формирования многослойной металлизации на них наносят припойные шариковые выводы. При этом одним из ключевых ограничений для сборки кристалла методом «flip-chip» является малый шаг контактных площадок на кристалле.
Цель данной статьи − показать возможность адаптации существующих полупроводниковых приборов с медной металлизацией кристаллов в составе полупроводниковых пластин к технологии сборки методом «flip-chip». В ряде случаев при проектировании кристалла интегральных микросхем (ИМС) в него не закладывается возможность использования технологии «flip-chip», а в ходе разработки и сборки изделий с этим кристаллом появляется потребность в её использовании. Применение системы перераспределения контактных площадок кристаллов позволяет решить эту проблему.
Для технологии микросварки проволокой контактные площадки обычно располагаются по периферии кристалла. Современные интегральные микросхемы с большим количеством входов/выходов (до нескольких тысяч) имеют равномерно распределённые по всей планарной стороне кристалла массивы контактных площадок под припойные шариковые выводы для монтажа методом «flip-chip». Такая конфигурация контактных площадок позволяет создавать свободную матрицу паяных соединений, которая ограничивается только геометрическими размерами полупроводникового кристалла и необходимым количеством контактных площадок [3]. Система, соединяющая контактные площадки по периферии кристалла и преобразующая их в матричную конфигурацию по всей площади кристалла с помощью тонкоплёночной металлизации, называется технологической системой перераспределения контактных площадок [3,4]. Она должна удовлетворять определённым требованиям, а именно, перераспределение контактных площадок кристаллов не должно ухудшать заданные технические характеристики и уменьшать надёжность исходных кристаллов.
Применение перераспределения контактных площадок с периферии кристалла по всей его площади позволяет приспособить кристалл к монтажу методом «flip-chip» и увеличить шаг выводов, что существенно снижает требования к подложкам и корпусам для «flip-chip» монтажа и, как следствие, снижает их стоимость и уменьшает массогабаритные размеры микросхем [3].
Перераспределение контактных площадок полупроводниковых кристаллов ИМС, гибридных интегральных микросхем (ГИС), микросборок, модулей, микроэлектромеханических систем (МЭМС) датчиков и других полупроводниковых приборов (ПП) на пластине с помощью создания дополнительных тонкоплёночных слоёв и металлизации на основе платины является перспективной технологией сборки методом «flip-chip». Ограничения по производительности и области применения полупроводниковых изделий могут приводить к существенным проблемам и вносить дополнительные сдерживающие факторы в их сборке и корпусировании. Рассмотрение таких проблем на начальных стадиях проектирования изделия часто игнорируется, хотя эти вопросы являются ключевыми.
Многослойная металлизация кристаллов на основе меди
Для изготовления высокопроизводительных изделий с проектными нормами 0,18 мкм и менее в качестве материала для перераспределения контактных площадок в настоящее время используют медь. Использование меди позволило сократить размеры токоведущих дорожек и уменьшить время задержки сигналов, что является важным моментом в производстве микропроцессоров, состоящих из элементов с субмикронными размерами [5, 6]. Переход на медь обусловлен меньшим значением удельного сопротивления по сравнению с другими широко применяемыми в микроэлектронике металлами, алюминием. В качестве пассивации и межслойной изоляции могут применяться различные тонкоплёночные полимерные материалы, плёнки из неорганических материалов и плёнки на основе кремнийорганических соединений. Одним из недостатков применения меди является высокая диффузионная подвижность, которая приводит к необходимости применения вокруг медных межсоединений диффузионных барьерных слоёв, нанесение которых требуется не только в области контактной площадки, но и на слой изолирующего диэлектрика, так как медь активно диффундирует через неё даже при низких температурах. Ещё одним из ограничений широкого применения меди является наличие летучих соединений при относительно низких температурах, что делает невозможным применение технологии непосредственного травления меди через фоторезистивную маску. Кроме этого, применение медной металлизации приводит к проблемам нанесения на стенки и дно узких и глубоких отверстий межслойных переходных соединений тонких барьерных слоёв для диффузии меди в смежные слои изолирующего диэлектрика [5]. Высокая диффундирующая способность меди через диэлектрические слои, такие как диоксид кремния, приводит к выводу интегральной схемы из строя.
Разработан способ изготовления полупроводниковых устройств с медными слоями перераспределения контактных площадок [5]. Способ включает в себя технологические операции формирования на полупроводниковых кристаллах кремниевой пластины медных слоёв металлизации с полимерным межслойным диэлектриком и технологию многослойной металлизации для контактных площадок под припойные шариковые выводы для монтажа кристаллов «flip-chip».
Многослойная металлизация кристаллов на основе платины
Введение платины в технологический процесс перераспределения контактных площадок основано на опыте применения платиновой металлизации на алюминиевых контактных площадках полупроводниковых кристаллов без применения перераспределяющих слоёв [7], в которых в качестве металлизации под припойный шариковый вывод использовался «stud-bump» (первая точка термозвуковой сварки на кристалле в соединении методом «шарик-клин») из платиновой проволоки. Применение данного способа позволяет сформировать припойные шариковые выводы на алюминиевых контактных площадках полупроводниковых кристаллов. Такой способ удобен для быстрого прототипирования. Формирование шариковых выводов без применения шаблонов снижает себестоимость выпускаемых полупроводниковых изделий, но вместе с тем трудоёмкость технологических процессов не позволяет сделать эту технологию массовой.
Использование платины в качестве металлизации системы перераспределения контактных площадок обусловлено следующими основными преимуществами: смачиваемостью припоями (адгезия к припоям); барьерными свойствами (практически не растворяется в припоях); защитными свойствами (практически не окисляется, стойкость к химическому воздействию); высокой электропроводностью (например, по сравнению с вольфрамом).
Для достижения уровня требований к системе перераспределения контактных площадок полупроводниковых кристаллов, которая не должна ухудшать заданные технические характеристики исходных кристаллов и уменьшать их надёжность, рекомендуется использовать металлизацию на основе платины, а в качестве пассивации и межслойной изоляции использовать тонкоплёночные диэлектрики.
Основные технологические операции применения платиновой металлизации в системе перераспределения контактных площадок кристаллов для сборки по технологии «flip-chip»
Применение платиновой металлизации в системе перераспределения контактных площадок кристаллов полупроводниковых изделий включает [8] нанесение репассивирующего слоя с последующим вскрытием контактных площадок кристаллов в составе полупроводниковой пластины, нанесение адгезионных и барьерных слоёв, нанесение слоёв металлизации и диэлектрических слоёв для перераспределения контактных площадок в матрицу контактных площадок по всей площади поверхности кристалла (рис. 1).
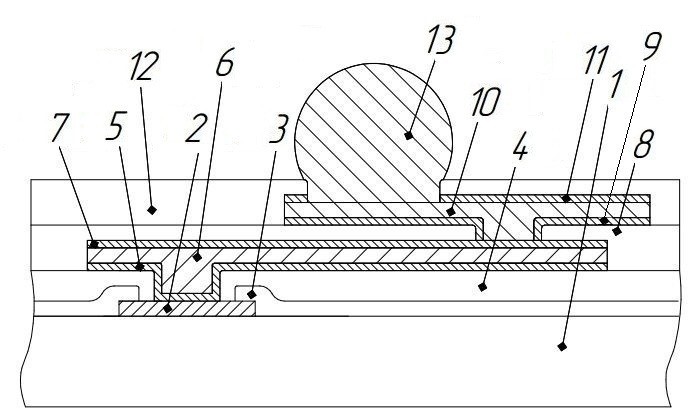
Вышеприведённая последовательность основных технологических операций даёт возможность создавать равномерно распределённые по планарной стороне кристалла контактные площадки, создавать свободную матрицу паяных соединений, которая ограничивается только геометрическими размерами полупроводникового кристалла и необходимым количеством электрических контактов для монтажа методом «flip-chip» [8, 9]. Когда количество контактных площадок и шаг между ними на кристалле не позволяют обойтись одним перераспределяющим слоем, возможно создание дополнительных тонкоплёночных перераспределяющих слоёв (TiN/Pt/TiN), разделённых межслойным диэлектриком (SiO2 илиSi3N4).
Данная технология позволяет исключить необходимость введения специализированной многослойной металлизации контактных площадок кристалла для перехода от технологии проволочной микросварки к технологии пайки и монтажу методом «flip-chip», так как предлагаемая система перераспределения контактных площадок уже включает весь функционал специализированной многослойной металлизации контактных площадок под пайку, а именно: хорошую смачиваемость различными припоями, защиту поверхности контактных площадок от окисления и коррозии, барьерные функции для предотвращения диффузии металла контактных площадок в смежные диэлектрические слои и диффузии припоя в металлизацию контактных площадок [8, 10, 11].
Также применение такого подхода даёт возможность изменять размеры, геометрию и структуру существующих контактных площадок под проволочный монтаж, что позволяет его использовать в биосовместимых медицинских приборах, таких как кардиостимуляторы и кардиодефибриляторы. Ввиду хорошей биосовместимости и рецепционных (измерительных) свойств платины она становится лучшим выбором для использования в медицинской сфере, например, в области электронных кардиоимплантов.
Заключение
Предлагаемая система перераспределения контактных площадок на основе платины обеспечивает по сравнению с существующими способами следующие преимущества:
- Возможность формировать равномерно перераспределённые по планарной стороне кристалла контактные площадки на всей поверхности полупроводниковой пластины, что позволяет создавать свободную матрицу паяных соединений, которая ограничивается только геометрическими размерами полупроводникового кристалла и необходимым количеством электрических контактов для монтажа методом «flip-chip».
- Возможность изменять размеры и геометрию существующих контактных площадок.
- Отсутствие недостатков широко применяемых материалов металлизации контактных площадок, таких как алюминиевая, медная и золотая, а именно: неспособность к пайке, подверженность окислению и реагирование со слабыми кислотами и щелочами для алюминиевой металлизации; окисление и диффузия припоя в металлизацию контактных площадок для медной металлизации; растворяемость в припоях для золотой металлизации контактных площадок.
- Отсутствие необходимости введения специализированной многослойной металлизации контактных площадок кристалла для перехода от технологии проволочной микросварки к технологии пайки и монтажу методом «flip-chip», так как предлагаемая система перераспределения контактных площадок уже включает весь функционал специализированной многослойной металлизации контактных площадок под пайку.
- Учитывая инертность платины и хорошую устойчивость к воздействию кислот и щелочей, предлагаемая система перераспределения не имеет ограничений на применение флюсов как для технологического процесса нанесения припойных шариков на кристалл, так и для процесса пайки кристалла на подложку или в корпус методом «flip-chip».
- Устойчивость работы полупроводниковых приборов в химически агрессивных средах.
- Отсутствие окисления, ионного загрязнения и деградации контактных площадок.
- Возможность применения в биосовместимых медицинских приборах.
- Технологические процессы перераспределения контактных площадок полупроводниковых кристаллов на полупроводниковой пластине с помощью создания дополнительных тонкоплёночных слоёв и металлизации на основе платины являются типовыми и в отличие от технологических процессов изготовления полупроводниковых пластин с медной металлизацией совместимы с технологическими процессами изготовления пластин с алюминиевой металлизацией и могут быть выполнены на одной технологической линии.
Конфликт интересов
Авторы подтверждают, что представленные данные не содержат конфликта интересов.
Литература
- Зенин, В.В. Монтаж кристаллов и внутренних выводов в производстве полупроводниковых изделий / В.В. Зенин, В.А. Емельянов, В.Л. Ланин. – Минск: Интегралполиграф, ¬ 2015. – 380 с. – ISBN 978-985-6845-51-5.
- М. Darnon and Т. Chevolleau, Т. David, J. Ducote, N. Posseme, R. Bouyssou, F. Bailly, D. Perret, O. Joubert. Patterning of porous SiOCH using an organic mask: Comparison with a metallic masking strategy. Journal Vacuum Science and Technology B, vol. 28, iss. 1, 2010, pp.149-156.
- Побединский, В.В. Платиновые стад-бампы с припойными шариками на алюминиевой металлизации кремниевых кристаллов в технологии flip-chip / В.В. Побединский, Н.В. Рогозин, Е.В. Лаврентьев, А.В. Рябов, В.В. Зенин, Е.Н. Бормонтов // Электронная техника. Серия 3. Микроэлектроника. – 2018. – Выпуск 2 (170). – С. 27-31.
- Method for manufacturing semiconductor devices having redistribution patterns with a concave pattern in a bump pad area, United States Patent (10) US (ID 6455408 B1 (51) H01L 21/44 (52) 438/613 / Chan Seung Hwang, Seung Ouk Jung; Filed Sep.28, 2000.
- Способ изготовления медной многоуровневой металлизации СБИС, Патент Рос. Федерации (19) RU (ID 240827 (13) C1 (51) H01L 21/283 (2006.01) / Красников Г.Я., Валеев А.С., Шелепин Н.А. и др.; с приоритетом от 11.01.2010.
- Clauberg H. Nickel–palladium bond pads for copper wire bonding. Microelectronics Reliability. 2011, vol. 51, no. 1, pp. 75-80.
- Патент № 2671383 Российская Федерация, H01L 21/321 (2006.01). Способ формирования шариковых выводов на алюминиевой металлизации контактных площадок кристалла: 2017144961: заявл. 20.12.2017 : опубл. 30.10.2018 / Зенин В.В., Рогозин Н.В., Побединский В.В. и др.; заявитель АО «Научно-исследовательский институт электронной техники». – 11 c.
- Заявка на изобретение Российская Федерация, H01L 21/321 H01L 21/321 Способ применения платиновой металлизации в системе перераспределения контактных площадок кристаллов интегральных микросхем и полупроводниковых приборов: 2019103914 / Рогозин Н.В., Побединский В.В.
- Flip chip metallization United States Patent (10) US (ID 6597069 B1 (51) H01L 23/50 (52) 257/778 . Yinon Degani, Jeffrey Alan Gregus.
- Савицкий, Е.М. Материаловедение платиновых металлов / Е.М. Савицкий. – М.: Металлургия, 1975. – 424 с.
- A.J. McAlister, D.J. Kahan The Al-Pt (Aluminum-Platinum) System, Bulletin of Alloy Phase Diagrams, 1986, vol. 7, no. 1, pp. 47-51.
References
- Zenin, V. V. Installation of crystals and internal leads in the production of semiconductor products / V. V. Zenin, V. A. Emelyanov, V. L. Lanin. – Minsk: Integralpart, 2015. – 380 p. – ISBN 978-985-6845-51-5.
- М. Darnon and Т. Chevolleau, Т. David, J. Ducote, N. Posseme, R. Bouyssou, F. Bailly, D. Perret, O. Joubert. Patterning of porous SiOCH using an organic mask: Comparison with a metallic masking strategy. J. Vac. Sci. Technol. В (28) 45 №1, Jan/Feb 2010 149-156).
- Pobedinsky V. V. Platinum stud-bumpers with solder balls on aluminum metallization of silicon die in flip-chip technology / V. V. Pobedinsky, N. V. Rogozin, E. V. Lavrentiev, A.V. Ryabov, V. V. Zenin, E. N. Bormontov – Electronic engineering. Episode 3. Microelectronics, Issue 2 (170), – 2018. Pp. 27-31.
- Method for manufacturing semiconductor devices having redistribution patterns with a concave pattern in a bump pad area, United States Patent (10) US (ID 6455408 B1 (51) H01L 21/44 (52) 438/613 / Chan Seung Hwang, Seung Ouk Jung; Filed Sep.28,2000.
- A method for manufacturing copper multilevel metallization VLSI circuit, patent Rus. Federation (19) RU (ID 240827 (13) C1 (51) H01L 21/283 (2006.01) / Krasnikov G. Ya., Valeev A. S., Shelepin N. A., etc.; with priority from 11.01.2010.
- Clauberg H. Nickel–palladium bond pads for copper wire bonding. // Microelectronics Reliability. 2004. vol. 51. no. 1. pp. 75-80.
- A method of forming a solder ball on the aluminum metallization of the contact pads of the die, the Patent Rus. Federation (19) RU (ID 2671383 (13) C1 (51) H01L 21/321 (2006.01) / Zenin V. V., Rogozin N. V., Pobedinsky V. V., etc. with priority from 20.12.2017.
- Method of application of platinum metallization in the system of redistribution of contact areas of die of integrated circuits and semiconductor devices, Application for the invention Rus. Federation (19) RU (ID 2019103914 (13) C1 (51) H01L 21/321 H01L 21/321 / Rogozin N. V., Pobedinsky V. V. with priority from 12.02.2019.
- Flip chip metallization United States Patent (10) US (ID 6597069 B1 (51) H01L 23/50 (52) 257/778 / Yinon Degani, Jeffrey Alan Gregus; Filed Sep.14, 2000.
- Savitsky E. M., The materials science of the platinum metals. Moscow: Metallurgiya, 1975. 424 PP.
- A.J. McAlister, D.J. Kahan, “The Al-Pt (Aluminum-Platinum) System”, Bulletin of Alloy Phase Diagrams, Vol. 7, No. 1, 1986 pp 47-51.
