ИССЛЕДОВАНИЕ ПОВЕДЕНИЯ ПОРОГОВОГО НАПРЯЖЕНИЕ ДМОП ТРАНЗИСТОРА С КОМБИНИРОВАННЫМ ПОДЗАТВОРНЫМ ДИЭЛЕКТРИКОМ НА ОСНОВЕ SIO2/SI3N4 В НОРМАЛЬНЫХ УСЛОВИЯХ И ПРИ ВОЗДЕЙСТВИИ ГАММА-ИЗЛУЧЕНИЯ
1. Введение
Одной из важнейших проблем современных кремниевых силовых полевых ДМОП транзисторов является стойкость к специальным внешним воздействующим факторам (СВВФ). В первую очередь к ним можно отнести различные ионизирующие излучения, а также воздействие тяжелых заряженных частиц. Все эти факторы оказывают негативное влияние на кристалл транзистора, вызывая ухудшение электрических параметров прибора. В наихудшем случае при определенных уровнях воздействия могут приводить к полному отказу прибора, что в свою очередь недопустимо в различных сферах эксплуатации.
2. Влияние гамма-излучения на пороговое напряжение традиционного дмоп транзистора
Гамма-излучение относится к ионизирующим излучениям и имеет очень высокую проникающую способность. В зависимости от интенсивности и времени воздействия на кристалл ДМОП транзистора гамма-излучение приводит к деградации основных электрических параметров таких как: ток утечки затвора, начальный ток стока, пороговое и пробивное напряжения.
Основной причиной ухудшения параметров является воздействие гамма-излучения на подзатворный диэлектрик. В объеме подзатворного диэлектрика, а также на границе раздела SiO2/Si всегда имеется встроенные положительные заряды (ловушки). Полная величина встроенного заряда зависит от многих факторов, например, таких как толщина и тип используемого диэлектрика, кристаллографическая ориентация кремниевой подложки, а также точность и чистота технологического процесса создания подзатворного диэлектрика [1].
Для n-канального транзистора при наличия электрического поля во время гамма-облучения в подзатворном диэлектрике начинается процесс ионизации, в результате которого образуются электронно-дырочные пары. Под действием электрического поля возникшие электроны за считанные пикосекунды начинают дрейфовать к поверхности поликремневого затвора, где они либо покидают диэлектрик, либо рекомбинируют. Этот процесс происходит быстро за счет того, что подвижность электронов в SiO2 значительно больше чем дырок. При этом часть дырок, оставшихся в диэлектрике также рекомбинируют с электронами, но большая их часть под действием электрического поля начинает движение через локализованные состояния в сторону границы раздела SiO2/Si, где они захватываются в имеющимися ловушками, увеличивая общий заряд и плотность поверхностный состояний на границе раздела SiO2/Si [2].
В свою очередь, все эти факторы будут оказывать существенное влияние на сдвиг порогового напряжения UЗИ ПОР транзистора. Поэтому для стандартных ДМОП транзисторов принято считать UЗИ ПОР как наиболее нестабильный параметр при поглощении гамма-излучения. На рисунке 1 представлена типовая зависимость порогового напряжения для n канального ДМОП транзисторов с подзатворным диэлектриком на основе SiO2 от поглощённой дозы гамма-излучения.
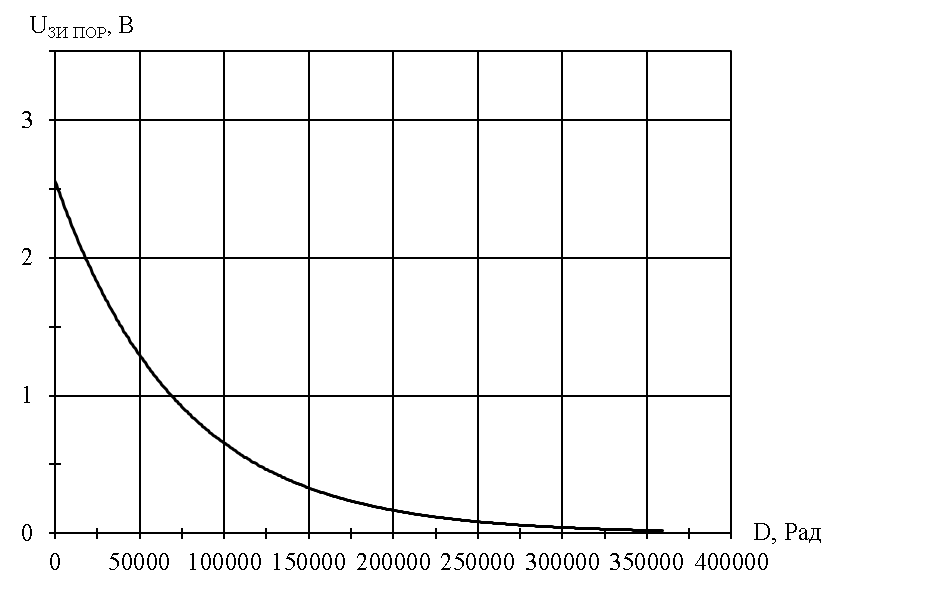
Как видно из рисунка 1, пороговое напряжение имеет выраженную тенденцию к снижению в зависимости от величины поглощённой дозы. Падение порогового напряжение продолжается вплоть до эффекта встроенного канала. Такой вид зависимости напрямую приводит к увеличению токов утечки, за счет более раннего открытия транзистора, тем самым повышая потребляемую мощность в пассивном режиме с появлением рисков преждевременного выхода транзистора из строя.
К сожалению, на сегодняшний день не существует модели, которая позволила бы точно описать влияние гамма радиационного воздействия на подзатворный диэлектрик. Учитывая тот факт, что процесс ионизации SiO2 является стохастическим процессом, то все из существующих моделей могут описывать происходящие процессы лишь приблизительно.
3. Определение порогового напряжение ДМОП транзистора с комбинированным диэлектриком на основе SiO2/Si3N4 в нормальных условиях и при воздействии гамма-излучения
На сегодняшний день, традиционная конструкция ДМОП транзистора имеет множество технологических аспектов роста подзатворного диэлектрика, которые позволяют создать близкий к идеальному, тонкий слой SiO2. Благодаря чему, у современных зарубежных фирм-производителей, изготавливаемые транзисторы имеют квазилинейных характер зависимости порогового напряжения от поглощённой дозы гамма-излучения, тем самым сфера их применения все больше и больше расширяется.
Альтернативным методом повышения стойкости к гамма-излучению является использование новых соединений или комбинаций материалов в качестве подзатворного диэлектрика. Например, в случае использования в качестве подзатворного диэлектрика комбинации SiO2/Si3N4 наблюдается изменение поведения порогового напряжения в зависимости от поглощённой дозы гамма-излучения относительно использования SiO2. Типовая зависимость порогового напряжения n канального ДМОП с подзатворным диэлектриком на основе SiO2/Si3N4 от поглощённой дозы гамма излучения представлена на рисунке 2.

Изменение поведения порогового напряжения связано с тем, что ввиду использования в конструкции транзисторного кристалла подзатворного диэлектрика на основе комбинации материалов SiO2 и Si3N4 происходит увеличение ловушек во всем объеме диэлектрика, в основном за счет слоя Si3N4, в котором изначально количество ловушек на порядки выше чем в слое SiO2. Однако начальный заряд слоя Si3N4 в отличии от SiO2, ввиду преобладания электронных ловушек, имеет отрицательную величину. К настоящему моменту механизм, описывающий изменение зарядов на границах Si/SiO2 и Si3N4 при воздействии гамма-излучения не описан. В соответствии с чем, также не могут быть подробно описаны сдвиги порогового напряжения.
Внесение в конструкцию дополнительного слоя диэлектрика Si3N4 ведет не только к изменению стандартной формы зависимости порогового напряжения n-канального ДМОП транзистора от поглощённой дозы, но и к воспроизводимости порогового напряжения в нормальных условиях.
При подаче на затвор транзистора напряжения величина которого меньше пробивного напряжения диэлектрика примерно на 30 %, возникает электрическое поле, величина которого способна вызвать изменение и перераспределение зарядов в слоях SiO2/Si3N4. Как было сказано выше, Si3N4 в отличие от SiO2 имеет значительно большее количество ловушек. Они в свою очередь располагаются глубоко и имеют энергию около 1,5 эВ. Заряд, полученный за счет высокого электрического поля может оставаться в Si3N4 неизменным на протяжении 10 лет при температуре не больше 85 °С и при условии отсутствия внешних электрических и радиационных воздействий. Данный эффект нашёл свое применение в энергонезависимых устройствах, таких как флэш-память [3].
В нашем случае возникновение эффекта памяти будет напрямую влиять на стабильность порогового напряжения. Например, на рисунке 3 представлены экспериментальные данные измерений зависимости тока стока от напряжения между затвором и истоком при нормальных условиях, а также после подачи на затвор напряжения +30 В.
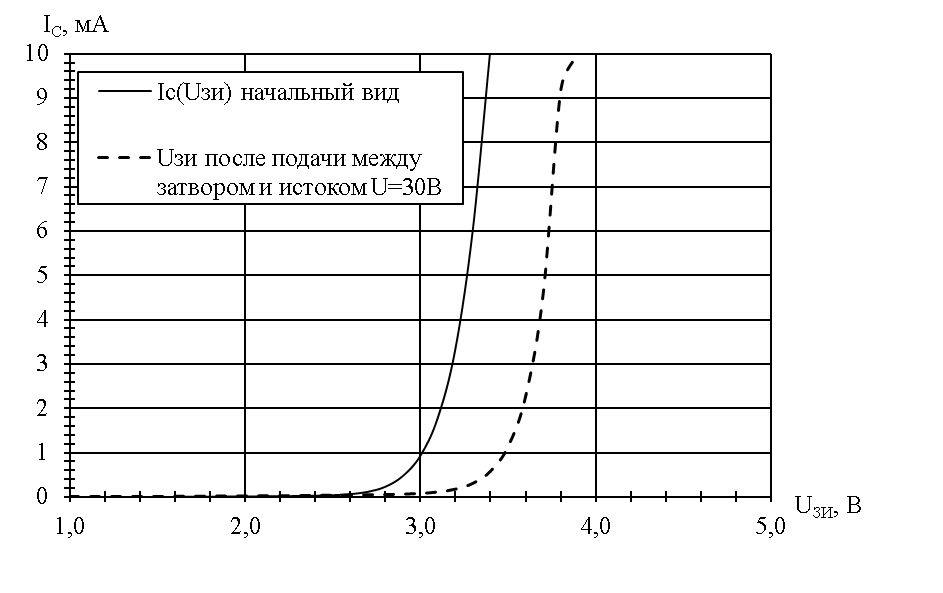
Из рисунка видно, что достаточно высокий положительный приложенный потенциал между затвором и истоком приводит к захвату части зарядов с границы SiO2/Si3N4 на глубокие ловушки в слое Si3N4. И наоборот, в следствие изменения потенциала затвора в отрицательную сторону, часть зарядов будет высвобождаться из ловушек. Таким образом характеристика порогового напряжения может сдвигаться как в положительную, так и в отрицательную сторону [4].
4. Исследование зависимости порогового напряжения ДМОП с различными толщинами SiO2/Si3N4 при воздействии гамма-излучения
Для подробного изучения эффектов воздействия гамма-излучения на ДМОП транзистор с комбинированным диэлектриком была произведена партия макетных транзисторных кристаллов, имеющих идентичную технологию и конструкцию изготовления и отличающихся лишь толщинами слоев подзатворных диэлектриков SiO2 и Si3N4. Каждый тип представлен двумя образцами транзисторов, имеющих одинаковые наборы толщин. Все данные по использованным вариациям толщин представлены в таблице 1.
Таблица 1. Данные толщин подзатворного диэлектрика для исследуемых образцов транзисторов.

Исследование проводилось на рентгеновской установке ISOVOLT TITAN. Известно, что рентгеновское и гамма-излучения приводят к одинаковым эффектам в ДМОП/МОП структурах. Единственное отличие — это способ формирования данных излучений: так как гамма-излучение является следствием естественно распада радиоактивных изотопов, а рентгеновское (тормозное) излучение возникает в рентгеновской трубке при создании термоэлектронной эмиссии в аноде и бомбардировке катода электронами в результате наличия между ними высокого напряжения, порядка 60-250 кВ [5].
В результате проведения исследований на стойкость к гамма-излучению для транзисторов, с различными толщинами подзатворного диэлектрика были получены экспериментальные зависимости, представленные на рисунке 4.
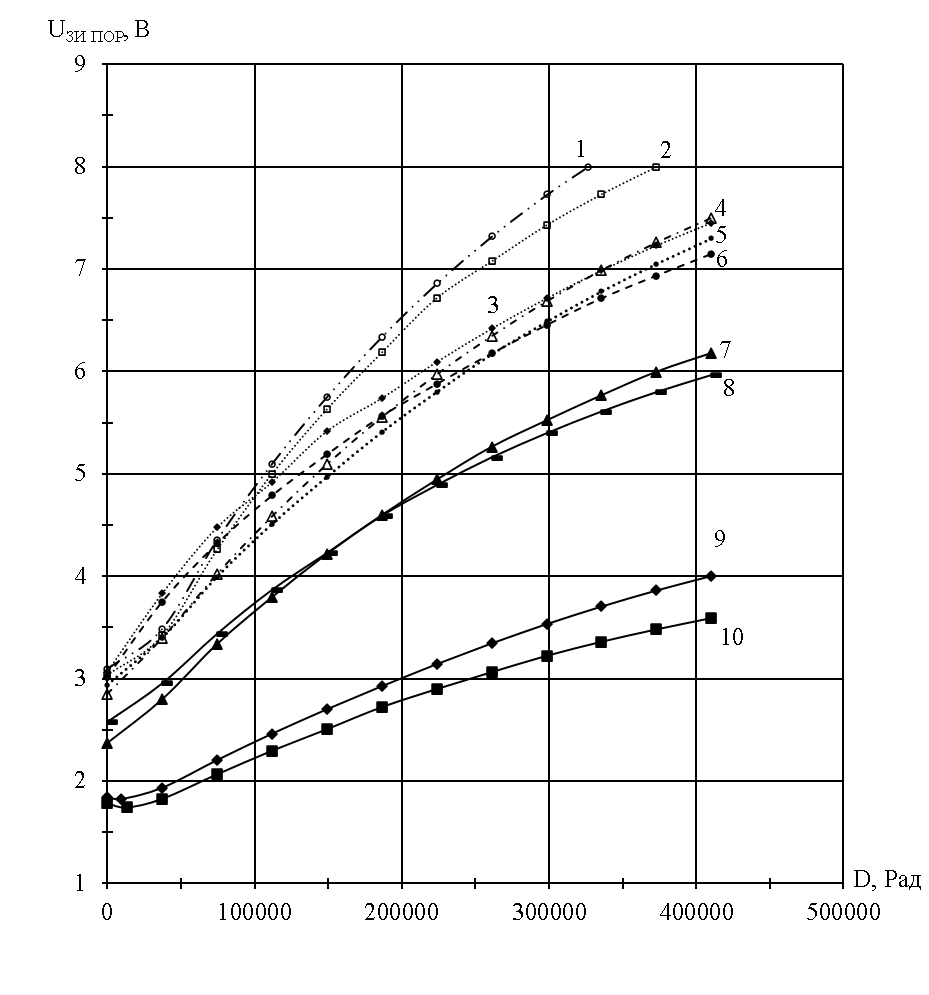
Из полученных зависимостей особый интерес вызывают две кривых № 9, 10, с одинаковой толщиной SiO2 – 300 Å и Si3N4 – 750 Å. На данных кривых за счет малой общей толщины 1050 Å наблюдается более низкий начальный уровень UЗИ ПОР, но помимо этого, за счет определенных соотношений толщин подзатворных диэлектриков удаётся снизить приращение ΔUЗИ ПОР(D) относительно всех остальных образцов. Данные значений в точках для двух кривых 9, 10 представлены в таблице 2.
Таблица 2. Данные изменений порогового напряжения от поглощённой дозы гамма-излучения для кривых 9, 10.

Согласно данным таблицы 2 при уровне поглощённой дозы более 400 кРад наблюдается численное изменение порогового напряжения ΔUЗИ ПОР на 1,8 В относительно начального значения. Если проводить корреляцию изменений ΔUЗИ ПОР порогового напряжения от поглощенной дозы с данными рисунка 1, то видно, что при фиксированном ΔUЗИ ПОР = 1,8 В различие между поглощенной дозой составляет более 300 кРад. Таким образом, добавление в конструкцию подзатворного диэлектрика дополнительного слоя Si3N4 и дальнейшие подобные исследования могут изменить представление о стойкости кремниевых ДМОП транзисторов к гамма-излучению.
5. Заключение
Использование комбинированного диэлектрика на основе SiO2/Si3N4 в ДМОП транзисторах с условием подбора оптимальных толщин может значительно повысить стойкость транзисторов к поглощённой дозе гамма-излучения, что в свою позволит расширить область их применения.
6. Литература
- Бородкин И.И., Кожевников В.А., Дикарев В.И. Влияние подзатворного диэлектрика Si3N4– SiO2 на электропараметры мощных кремниевых СВЧ LDMOS транзисторов. // Межвузовский сборник научных трудов Твердотельная электроника, микроэлектроника и наноэлектроника, 2015, В. 14 – С.4-8.
- Гриценко В.А. Структура границ раздела кремний/оксид и нитрид/оксид. // Успехи физических наук, 2009, Т. 179, №9. – С. 921-930.
- Nasyrov K. A., Gritsenko V. A., Novikov Y. N. Two-bands charge transport in silicon nitride due to phonon-assisted trap ionization. // Journal of applied physics, 2004. Vol. 96, № 8, pp. 4293-4296
- Jiongjiong Mo, Xuran Zhao, Min Zhou Total Ionizing Dose Effects of Si Vertical Diffused MOSFET with SiO2 and Si3N4/SiO2 Gate Dielectrics. // Active and Passive Electronic Components, Vol. 2017, 7 p.
- Мокрушина С.А., Н.М. Романов Сравнение отклика МОП-транзистора на воздействие рентгеновского и гамма-облучения. // Известия вузов России. Радиоэлектроника. 2020, Т. 23, № 1. – С. 30–40.
References
- Borodkin I.I., Kozhevnikov V.A., Dikarev V.I. Influence of the Si3N4- SiO2 gate dielectric on the electrical parameters of high-power silicon microwave LDMOS transistors. // Interuniversity collection of scientific papers Solid–state electronics, microelectronics and nanoelectronics, 2015, Vol. 14 – pp.4-8.
- Gritsenko V.A. The structure of the silicon/oxide and nitride/oxide interface. // Successes of Physical Sciences, 2009, Vol. 179, № 9. – pp. 921-930.
- Nasyrov K. A., Gritsenko V. A., Novikov Y. N. Two-bands charge transport in silicon nitride due to phonon-assisted trap ionization. // Journal of applied physics, 2004. Vol. 96, № 8, Pp 4293-4296
- Jiongjiong Mo, Xuan Zhao, Min Zhou Total Ionizing Dose Effects of Si Vertical Diffused MOSFET with SiO2 and Si3N4/SiO2 Gate Dielectrics. // Active and Passive Electronic Components, Vo. 2017, 7 p.
- Mokrushina S.A., N.M. Romanov Comparison of the response of a MOSFET to the effects of X-ray and gamma radiation. // News of Russian universities. Radio electronics. 2020, Vol. 23, № 1. – pp. 30-40.
